Au88Ge12金锗合金预成型焊带/焊片
Au88Ge12金锗合金具有低蒸气压、低基础电阻、低熔化温度、与衬底粘附性好、高导电性和导热性等优点。其作为一种共晶焊料,在芯片焊接封装等领域得到广泛应用。
Au88Ge12金锗合金具有低蒸气压、低基础电阻、低熔化温度、与衬底粘附性好、高导电性和导热性等优点。其作为一种共晶焊料,在芯片焊接封装等领域得到广泛应用。
Au88Ge12金锗合金预成型焊带/焊片
Au88Ge12金锗合金具有低蒸气压、低基础电阻、低熔化温度、与衬底粘附性好、高导电性和导热性等优点。其作为一种共晶焊料,在芯片焊接封装等领域得到广泛应用。常用在电子产品、电真空器件焊接及高温焊接和某些特殊材料的焊接,在大气或H2气炉中钎焊镀金可伐,镀银铝材,Ag、Cu、Ni、可伐合金等,特别适用于钎焊高真空系统中使用的器件。



金锗合金的基本性能:
金锗合金为共晶合金,共晶点成分12wt%Ge,共晶温度356℃。如下图:
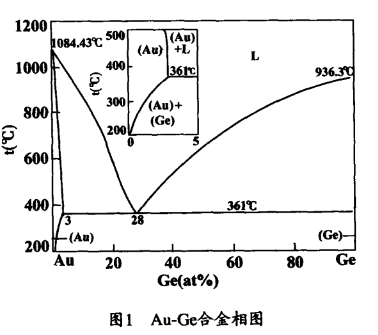
金锗合金具有适合用作封装材料的性能:
1、低的封接温度。金锗合金(共晶合金)熔点为356℃,钎焊温度为380~400℃。
2、良好的润湿性及耐腐蚀性。具有良好的流散性和浸润性且对镀金层无浸蚀现象,其合金含88wt%Au,与镀金层的成分接近,因而通过扩散对很薄镀层的浸溶程度很低。
3、高的抗拉强度。在室温下的抗拉强度约为220MPa,与一些高温钎料的强度相当,但整个钎焊过程在相对低得多的温度下完成。
4、低的热膨胀系数。电子器件的组装及服役过程中,材料热膨胀系数CTE的非匹配是造成封装失效的一个重要原因,因此电子封装材料的热膨胀系数必须足够低,才能与相互连接的硅元件的特性相匹配。金锗合金的CTE比同样用作电子封装的AuSn和AuSi更低。
5、良好的导热性能。金锗合金在微电子器件中可起到为半导体芯片提供机械支撑、接通半导体芯片的电流通路,散逸半导体芯片产生热的作用。
6、较低的蒸气压。
7、比银基合金有更好的耐腐蚀和抗氧化性能。
8、良好的流散性。
9、高温稳定性较好。焊接时一般不形成脆性相,因而焊接强度高。